
Spectroscopic ellipsometry
Spectroscopic ellipsometry
Spectroscopic ellipsometry is an optical characterisation technique which provides a highly sensitive, contactless method for thin film measurements. Multiple light wavelengths and variable angles of polarised light are reflected off the surface of a sample. As this light reflects, its characteristics change depending on a number of the sample’s properties – it can therefore be used to characterise film thickness as well as composition such as roughness, crystalline nature, electrical conductivity and doping concentration.
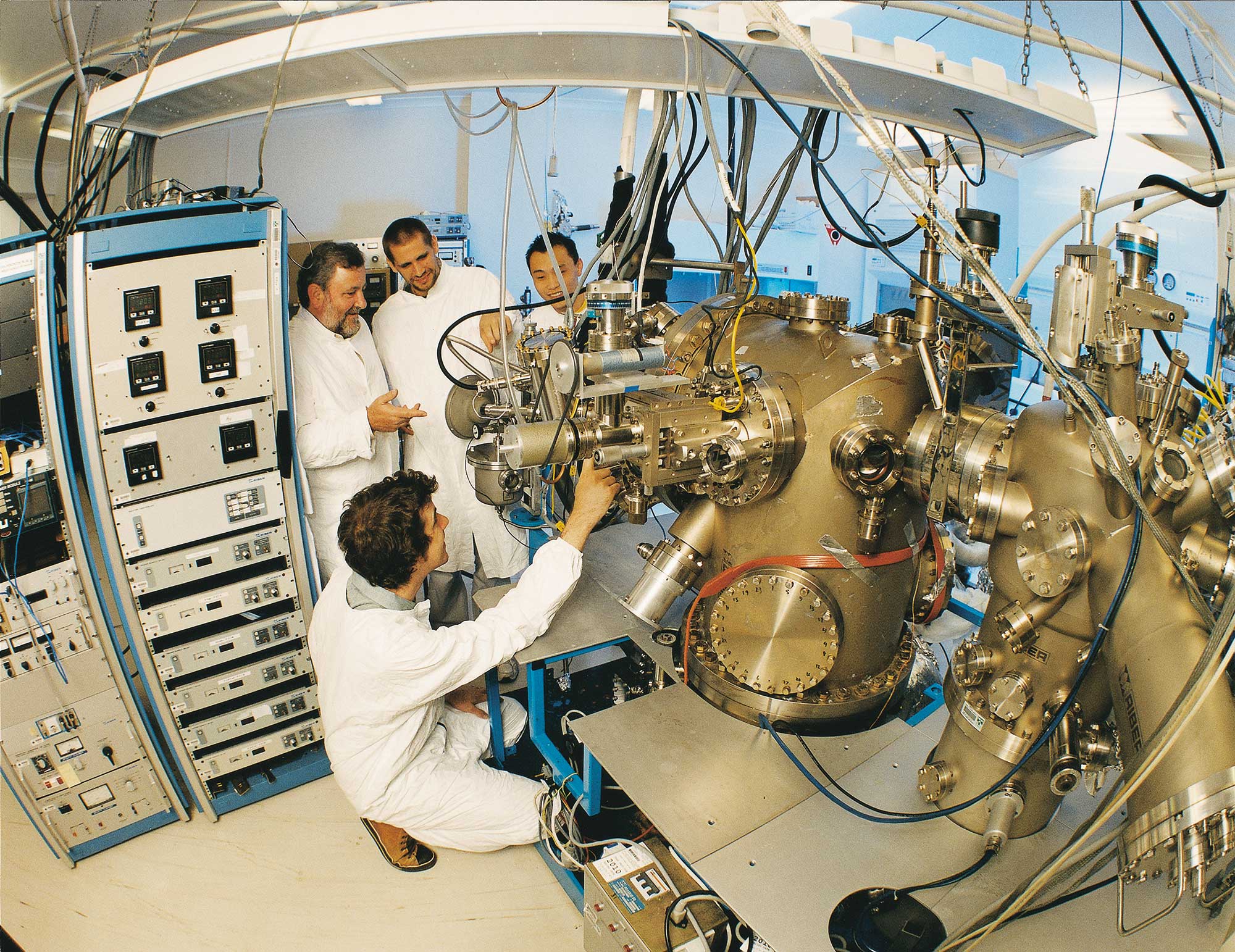
List of available equipment
TOOL MAKE AND MODEL
KEY DIFFERENTIATOR
LOCATION
J. A. Woollam M-2000-DI
Spectral Ellipsometer
ACT Node
Australian National University (ANU)
Description
Fully automated spectral ellipsometer to measure refractive index and thickness of materials.
Related Information
Spectral Range of 193 to 1,700 nm.
Tool Contact
horst.punzmann@anu.edu.au
J. A. Woollam VUV VASE (Gen-II)
Variable angle spectroscopic ellipsometer
QLD Node
University of Queensland
Description
Versatile, easy to use ellipsometer for measurement of optical properties, film thickness and refractive index.
Related Information
Sample substrates up to 50 mm. Spectral range of 140 - 1700 nm. Incident angle between 40 - 90° using XY stage.
Tool Contact
anff@uq.edu.au
J.A. Woollam IR-VASE
Measuring complex refractive index or dielectric function of thin films.
Optofab Node
University of Adelaide
Description
Common measurements include coating thickness, IR refractive indices and molecular bond vibrations.
Related Information
Specification: 1.7 to 30 μm (333 to 5900 wavenumbers)
Tool Contact
optofab@adelaide.edu.au
TOOL MAKE AND MODEL
KEY DIFFERENTIATOR
LOCATION
J. A. Woollam M-2000-DI
Spectral Ellipsometer
Optofab Node
University of Adelaide
Description
Fully automated spectral ellipsometer to measure refractive index and thickness of materials.
Related Information
Spectral Range of 193 to 1,700 nm.
Tool Contact
horst.punzmann@anu.edu.au
TOOL MAKE AND MODEL
KEY DIFFERENTIATOR
LOCATION
J. A. Woollam VUV VASE (Gen-II)
Variable angle spectroscopic ellipsometer
Optofab Node
University of Adelaide
Description
Versatile, easy to use ellipsometer for measurement of optical properties, film thickness and refractive index.
Related Information
Sample substrates up to 50 mm. Spectral range of 140 - 1700 nm. Incident angle between 40 - 90° using XY stage.
Tool Contact
anff@uq.edu.au
TOOL MAKE AND MODEL
KEY DIFFERENTIATOR
LOCATION
J.A. Woollam IR-VASE
Measuring complex refractive index or dielectric function of thin films.
Optofab Node
University of Adelaide
Description
Common measurements include coating thickness, IR refractive indices and molecular bond vibrations.
Related Information
Specification: 1.7 to 30 μm (333 to 5900 wavenumbers)
Tool Contact
optofab@adelaide.edu.au
